Важными операциями на этапе подготовки кремниевых пластин при производстве ИМС и СБИС являются их шлифовка и полировка, которые осуществляются химико-механической обработкой. Еще одним этапом производства СБИС, связанным с выравниванием обрабатываемой поверхности, является ее планаризация, которая проводится при формировании рабочих слоев. Для проведения планаризации поверхности требуется провести ряд операций, включающий нанесение фоторезистивного слоя методом центрифугирования и последующее его плазмохимическое неселективное по отношению к рабочему слою травление.
В данном докладе описан метод обработки поверхности локализованным газовым разрядом (ЛГР), уникальные свойства которого описаны в [1, 2], который предлагается использовать для выполнения перечисленных выше задач. Это ВЧ — емкостной разряд, который зажигается при давлениях ( Р ) лежащих в диапазоне 10 4– 3·10 4 Па и длинах разрядного промежутка ( L ) порядка 100 мкм. При фиксированной длине свободного пробега электронов и L , меньшем некоторого значения, электронная лавина не может образоваться под выступающими элементами электрода. В этом случае наблюдается зажигание разряда в направлении участков поверхности противоположного электрода, удаленных на расстояние, достаточное для образования электронной лавины.
В данном случае используется тот факт, что ЛГР может формироваться не над всей обрабатываемой поверхностью, а только над теми ее участками, которые наиболее приближены к электроду, что иллюстрирует рисунок 1.

Рис. 1. Обрабатываемый материал, 2 — ВЧ электрод, 3 — плазма
Такой характер горения ЛГР приводит к выравниванию поверхности материала 1, расположенного на заземленном электроде (рис.1). Для этого поверхность ВЧ электрода 2 должна быть плоскопараллельной. В процессе травления микроразряды формируются и перемещаются по поверхности по мере стравливания выступающих ее участков. Степень локализации ЛГР определяется составом газа, величинами Р и L.
В работе [1] была получена зависимость скорости травления от межэлектродного расстояния, имеющая максимум (рис.2). На начальном участке при увеличении межэлектродного расстояния скорость растет, что можно объяснить уменьшением скважности между периодами горения разряда. В тоже время с увеличением L уменьшается напряженность электрического поля, что приводит к уменьшению доли электронов с энергией, большей энергии диссоциации молекул, а максимум смещается в сторону меньших L .
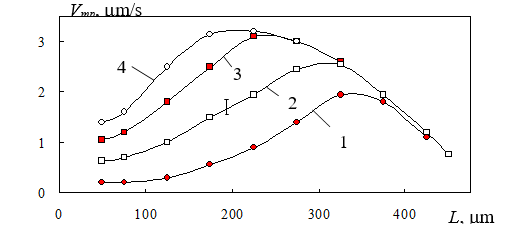
Рис. 2. Зависимость скорости травления кремния от межэлектродного расстояния. Газ SF 6 , l = 100 мкм, W = 30 Вт, U = 135 B, SF 6 , p = 10 4 (1), 1,510 4 (2), 210 4 (3), 2,510 4 Па (4)
В работе [2] показано, что механизм процесса травления ЛГР Si, SiO 2 локализованным разрядом имеет преимущественно химическую природу, как и традиционное плазмохимическое травление. Об этом свидетельствуют, например, значения селективности представляемого процесса. Так, отношение скоростей травления Si и SiO 2 при переходе от газа SF 6 к CF 4 изменялось от 6 до 0,5. Другим фактом, подтверждающим химическую природу рассматриваемого процесса, является изотропный характер травления Si в тех же газах, но уже проводимого через алюминиевую маску. Эксперименты по травлению Si и SiO 2 локализованным разрядом в аргоне показали, что физическим распылением этих материалов можно пренебречь ввиду низкой энергии ионов, которая здесь не превышает нескольких десятков электрон-вольт.
В то же время анализ результатов, как экспериментов, так и моделирования свидетельствуют о том, что в процессе травления локализованным разрядом Si (и особенно SiO 2 ), немаловажную роль играет ионная бомбардировка, как фактор активации и очистки обрабатываемой поверхности.
Учитывая химический характер травления локализованным разрядом, регулирование скорости можно проводить, изменяя состав газовой смеси. Показано, что влияние добавок Ar, O 2 и воздуха на скорость травления имеют существенные различия в газах SF 6 и CF 4 . Так разбавление SF 6 аргоном приводит к практически линейному спаду скорости травления кремния во всем исследуемом диапазоне, в то время как в CF 4 скорость травления практически не меняется при добавлении до 70 % аргона.
Зависимости скорости травления кремния от содержания кислорода в газах SF 6 и CF 4 имеют максимум, причем наиболее сильно это проявляется для CF 4 . Так максимум скорости наблюдается при 30 % O 2 , а скорость травления кремния при этом увеличивается в 4 раза. Такой характер зависимости связан с тем, что добавка кислорода в исходный газ приводи к появлению в разряде большего количества свободного фтора в виде атомов и молекул.
Вместе с тем, исследуемый процесс имеет и существенные отличия от плазмохимического и реактивного ионно-плазменного травления. В первую очередь выделим чрезвычайно высокую скорость травления, которая обусловлена весьма значительной концентрацией химически активных частиц (ХАЧ) в разряде. Поскольку разряд локализуется лишь у выступающих элементов электрода, объем его чрезвычайно мал, в зависимости от площади обрабатываемой поверхности, он может составлять от 0.01 до 100 мм 3 . Это позволяет без дополнительных затрат электроэнергии получать плотность мощности в разряде на 4–5 порядков большую и скорости травления материалов в десятки раз выше, достигаемых в традиционных системах плазменного травления.
Например, в газе SF 6 для Si и SiO 2 значения скоростей достигают 10 и 0,5 m/s, соответственно. В работе [2] была показана возможность регулировки скорости ЛГР, как с помощью технологических параметров системы, так и учитывая физико-химическую природу процесса травления. Это позволяет прогнозировать результат обработки материала с учетом конкретных задач.
На рисунке 3 представлены фотографии поверхности шлифованного Si до (а) и после обработки (б) с помощью ЛГР. Плазмообразующий газ — SF6, Р = 80кПа, Urf =200В, время обработки — 2с.
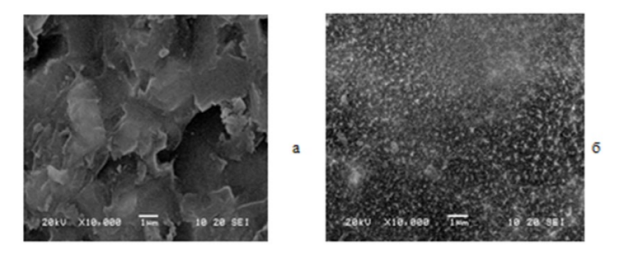
Рис. 3. Фотографии поверхности шлифованного Si до (а) и после обработки (б) с помощью ЛГР. Плазмообразующий газ — SF 6 , Р = 80 кПа, U rf =200В, время обработки — 2с
Представленный способ выравнивания поверхности Si может быть применен для обработки поверхности других материалов. Процесс травления материалов с помощью ЛГР обусловлен взаимодействием с радикалами молекул рабочего газа. Вклад ионной бомбардировки заключается в активации поверхности, поскольку рабочие значения U rf при горении ЛГР лежат в диапазоне от 100 до 250 В.
В настоящее время плазменные методы гравировки поверхности различных материалов широко применяются в микроэлектронном производстве. Более широкое применение плазмы для обработки материалов ограничиваются относительно невысокими значениями достигаемых скоростей травления и их технологической сложностью процесса. Последняя, в частности, связана с необходимостью формирования масок на обрабатываемых поверхностях посредством серии литографических операций. При этом воздействию частиц плазмы подвергаются не только травящиеся участки поверхности материала, но также сама маска и большая часть поверхности разрядной камеры. Это приводит к неэффективному расходованию электроэнергии и плазмообразующих газов.
Представляемая нами технология может быть успешно использована при производстве микросистемой техники, изделий микроэлектроники и других устройств, изготовляемых путем изменения топологии поверхностей различных материалов, в том числе, путем формирования объемных конфигураций. В связи с этим будет решаться задача по исследованию физико-химических закономерностей взаимодействия таких разрядов с различными материалами.
Результаты проведенных исследований могут быть использованы так же при разработке конструкций и технологий изготовления различных газоразрядных приборов, например, газовых лазеров, плазменных дисплеев и др.
Представляемая технология имеет огромные перспективы реализации в производстве, роботостроении, медицине и других отраслях.
Преимущество применения ЛГР для размерной обработки поверхности материалов заключается в отсутствии необходимости проведения дополнительных операций и больших скоростях травления. Для решения задач промышленной спинтроники технология ЛГР имеет несомненные преимущества перед традиционными технологиями — высокая производительность, экологичность, универсальность, энергосбережение.
Литература:
- Абрамов А. В., Панкратова Е. А., Суровцев И. С. Скорость травления кремния локализованным газовым разрядом. ЖТФ (2014).84(10). 34–38.
- Абрамов А. В., Панкратова Е. А., Суровцев И. С., Золототрубов Д. Ю. Характеристики локализованного газового разряда. ЖТФ. (2016), 86(1), 50–54.







