МЭМС для аэрокосмических структур нового поколения позволяют миниатюризировать датчики, но в силу физических ограничений, а также повышенных требований по надежности и ресурсу обуславливают поиски новых материалов с улучшенными физическими и механическими параметрами [1]. Отличием таких материалов является прямой отклик на механические воздействия за счет применения адаптивных смарт-материалов и структур, способных реагировать на изменения внешних или внутренних условий (изменяя свое статическое и динамическое поведение).
Для изготовления высокоэффективных МЭМС, работающих при дестабилизирующих условиях на конструкциях РКТ, наиболее перспективными являются материалы, реализующие прямой и обратный пьезоэффект. Данный принцип детектирования является альтернативным, традиционно используемому тензорезистивному и емкостному методам, широко распространенным в связи с применением кремниевой и тонкопленочной технологий. Использование смарт-материалов в качестве преобразующего элемента позволяет качественно расширить возможности МЭМС: пороговая чувствительность сенсоров динамической деформации на основе пьезоэлектрических пленок уменьшается до Δl/l~10–9-10–10. При этом чувствительность датчиков на основе МЭМС-технологий повышается на два порядка, при сохранении долговременной стабильности не требуются источники стабилизированного напряжения [2].
Малые габариты и масса тонкопленочных пьезоэлектрических датчиков, высокая механическая прочность и гибкость пленочных преобразователей обеспечивают контроль поверхностей переменной во времени кривизны в условиях больших механических нагрузок без внесения искажений в регистрируемую информацию [3].
В работе проведены исследования технологических условий формирования микрокантилеверной балки слоистых гетероструктур на основе интеграции смарт-материала и карбида кремния. По своим механическим характеристикам он уступает только алмазу, но более технологичен из-за минимальной разницы температурных коэффициентов линейного расширения с ЦТС керамикой (ТКЛР SiC — 4.51∙10–6 К-1; ТКЛРЦТС — 3,5∙10–6 К-1; ТКЛРUNCD — 1,1∙10–6 К-1) при получении таких гетероструктур и возможности проведения фотолитографии для формирования соответствующего рисунка топологии [4]. Другой причиной несовместимости алмазоподобных пленок с пленками на основе ЦТС является сложность в получении алмазных слоев с низким значением шероховатости поверхности, в связи с этим наблюдается снижение пьезоэлектрической постоянной пьезоэлемента [5].
Тонкопленочные гетероструктуры карбид кремния — ЦТС формировались на кремниевой подложке при помощи ВЧ-магнетронного распыления керамической мишени состава PbZr1-xTixO3 в атмосфере кислорода и мишени из карбида кремния в атмосфере аргона [5]. На кремниевой подложке последовательно сформированы слои двуокиси кремния (SiO2), нитрида кремния, карбида кремния и платины (нижний электрод). Двуокись кремния толщиной 0,2–0,5 мкм получена термическим окислением. Нитрид кремния получен CVD методом осаждения из газовой фазы в плазме из отношения газов аммиака, моносилана и аргона. Данный слой жертвенный при вытравливании балки. Пленка карбида кремния толщиной 1 мкм получена ВЧ-магнетронным распылением с последовательным ионным ассистированием для получения необходимой шероховатости поверхности, приближая границу раздела с пленкой ЦТС к монофазной. Методом резистивного испарения нанесен нижний электрод из платины толщиной 0,8 мкм. Толщина сегнетоэлектрической пленки ЦТС составила 0,4 мкм, при температуре осаждения 150°С. Перед нанесением сегнетоэлектрической пленки проводилась обработка поверхности платины ионным источником, а затем и процесс осаждения сегнетоэлектрической пленки чередовался с обработкой осаждаемой поверхности ионным источником, благодаря чему увеличивалась сплошность пленки. Температура отжига составляла 530 °С, время отжига 40 минут. Верхний электрод толщиной 0,8 мкм получен резистивным испарением. Травление жертвенного слоя осуществляли при помощи плазмохимического травления.
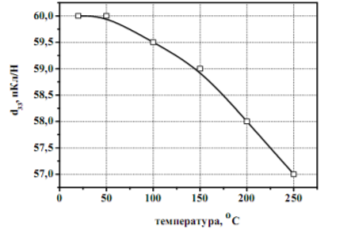
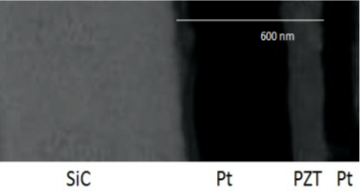
Рис. 1. Температурная зависимость остаточного пьезомодуля d33 пленки ЦТС, поляризованной горячим способом и РЭМ снимок поперечного разреза гетероструктуры Pt/PZT/Pt/SiC
На рисунке 1 представлена температурная зависимость d33 (Т). Видно, что при нагреве до 250 °С d33 уменьшается не более чем на 10 % и, главное, отсутствует эффект деполяризации образца, что согласуется с [6–8].
Наблюдали эффект увеличения остаточного пьезомодуля сразу после создания устойчивого поляризованного состояния в пленках из-за продолжающихся процессов ее поляризации в поле зарядов, захваченных на ловушки в объеме пленки в соответствии с [2].
Исследование границы раздела полученной гетероструктуры выполнено на растровом электронном микроскопе (рисунок 1).
Литература:
- Баринов И. Н. Высокотемпературные тензорезистивные датчики давлений на основе карбида кремния. Состояние разработок и тенденции развития // Компоненты и технологии. 2010, № 8. С. 64–71.
- Мухортов В. М., Юзюк Ю. И. Гетероструктуры на основе наноразмерных сегнетоэлектрических пленок: получение, свойства и применение. — Ростов на Дону: ЮНЦ РАН, 2008. С. 224
- ScottJ.F. // FerroelectricsRev.1998. Vol.1.P.1
- Лучинин В., Таиров Ю. Отечественный полупроводниковый карбид кремния: шаг к паритету // Современная электроника. 2009. № 7. С. 12–15.
- T. Shibata, K. Unno, E. Makino, and S. Shimada, Sensors and Actuators A: Physical 114, 398 (2004).
- Б. Яффе, У. Кук, Г. Яффе. Пьезоэлектрическая керамика. Мир, М. 1974. С. 288.
- Баринов И. Н., Волков В. С. Конструктивно-технологические проблемы обеспечения долговременной стабильности параметров высокотемпературных полупроводниковых тензорезистивных датчиков давлений // Известия высших учебных заведений. Поволжский регион. Технические науки. Спец. выпуск № 3.-2011 г.- С. 85–95.
- Аверин И. А. Управление составом многокомпонентных систем / И. А. Аверин, Р. М. Печерская // Известия высших учебных заведений. Поволжский регион. Естественные науки — 2006. — № 5. — С. 184–190.







